機(jī)箱設(shè)計(jì)貌似簡(jiǎn)單,但卻蘊(yùn)含了intel巨大的“陽謀”。從當(dāng)年旨在降低“Presscot”核心的38℃機(jī)箱,再到去年同時(shí)兼顧CPU和顯卡散熱的TAC 2.0機(jī)箱,無不如此。
我們先來簡(jiǎn)單回顧38℃機(jī)箱的歷史。“38℃機(jī)箱”實(shí)為通俗說法,實(shí)際是intel早在02年和03年分別提出的CAG 1.0(chassis air guide)和CAG 1.1規(guī)范。03年,intel推出被業(yè)界詬病多年的“Presscot”核心處理器,此時(shí)傳統(tǒng)的機(jī)箱(指不符合CAG標(biāo)準(zhǔn))已經(jīng)不能滿足“Presscot”的散熱要求,增加了CPU導(dǎo)風(fēng)管和顯卡散熱孔的38℃機(jī)箱由intel攜各大機(jī)箱廠商粉墨登場(chǎng),并成為主流DIY機(jī)箱的唯一標(biāo)準(zhǔn)。

38℃機(jī)箱的特點(diǎn)之一就是為CPU風(fēng)扇提供專門的風(fēng)道,從而改善CPU的散熱

38℃機(jī)箱風(fēng)道原理
在摩爾定律的帶領(lǐng)下,CPU和顯卡的發(fā)熱量有了巨大的變化。全新的工藝和架構(gòu)讓intel處理器擺脫了“高頻低能”的稱號(hào),同時(shí)nVIDIA和AMD的性能競(jìng)賽反倒讓顯卡成為了新一代的“冬天暖手器”。另一方面,也是最為重要的原因:最新的intel I5、I3處理器內(nèi)置PCI-E總線控制器,原本位于CPU和PCI-E插槽之間的北橋芯片被省略,CPU底座和PCI-E插槽直接走線連接,同時(shí)縮短蛇形走線的長(zhǎng)度可大大提高頻率的穩(wěn)定性,因此P55主板的CPU底座和PCI-E插槽的距離遠(yuǎn)遠(yuǎn)短于它們?cè)?/FONT>X58、P45、785G等主板的距離。

縮短CPU底座和PCI-E之間的距離是眾多P55主板設(shè)計(jì)的共性
換句話說,在P55平臺(tái)和以后的H55、H57平臺(tái)上,CPU和顯卡這兩大熱源的距離比以往的平臺(tái)更接近,散熱環(huán)境和要求更復(fù)雜。另一方面,38℃機(jī)箱中的導(dǎo)風(fēng)孔也極容易對(duì)P55平臺(tái)的安裝和散熱帶來不利的影響。因此,新的機(jī)箱標(biāo)準(zhǔn)便應(yīng)運(yùn)而生。
TAC 2.0(Thermally Advantaged Chassis)是繼CAG 1.0、CAG 1.1之后,intel主導(dǎo)的第三個(gè)機(jī)箱標(biāo)準(zhǔn)。主要針對(duì)CPU和GPU發(fā)熱源距離縮短和GPU發(fā)熱大增而設(shè)計(jì)的標(biāo)準(zhǔn)。

TAC 2.0機(jī)箱草圖
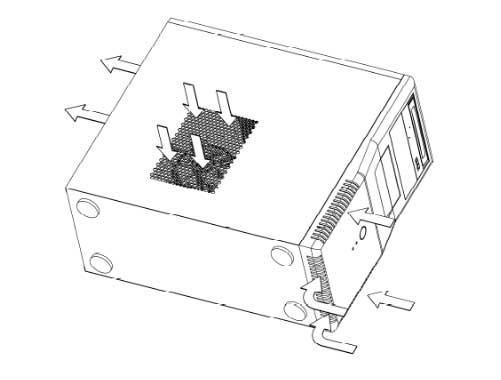
TAC 2.0機(jī)箱草圖
相比于CAG 1.0/ CAG 1.1標(biāo)準(zhǔn),TAC 2.0標(biāo)準(zhǔn)有兩大改進(jìn)之處。一是去掉了導(dǎo)風(fēng)管,二是把CPU和GPU的進(jìn)風(fēng)孔二合為一,并增大了進(jìn)風(fēng)孔總面積。前文已經(jīng)分析過,新的P55等主板的CPU底座和PCI-E插槽距離明顯縮短,CPU底座位置也明顯下移,和原有的38℃機(jī)箱有明顯的安裝沖突。為此TAC 2.0標(biāo)準(zhǔn)里把導(dǎo)風(fēng)管去掉,既增加空氣流動(dòng)性,也避免了它和顯卡沖突的可能。而擴(kuò)大面積的進(jìn)風(fēng)孔則正好滿足GPU和CPU兩熱源更為接近的要求。
CPU的目標(biāo)溫度從CAG 1.0/ CAG 1.1標(biāo)準(zhǔn)的38℃提升到了TAC 2.0標(biāo)準(zhǔn)的40℃。而顯卡則有望在增加了進(jìn)風(fēng)孔面積的幫助下,獲得更大的空氣流通量、取得更好的降溫效果。由此可見,TAC 2.0規(guī)范在一定程度上犧牲了CPU的散熱條件,并傾斜至顯卡上,這一方面源于CPU功耗和發(fā)熱量的顯著改善,同時(shí)也顧及于功耗日益增大的顯卡。

TAC 2.0機(jī)箱(航嘉暗夜公爵)

TAC 2.0機(jī)箱的進(jìn)風(fēng)孔(航嘉暗夜公爵)
TAC 2.0標(biāo)準(zhǔn)的趨勢(shì)分析:北橋芯片逐漸從主板中消失是未來趨勢(shì),一方面符合半導(dǎo)體集成度越來越高的規(guī)律,另一方面也滿足降低成本的經(jīng)濟(jì)效益要求。AMD平臺(tái)早在06年便涌現(xiàn)了多款單芯片的主板,而此次intel推出的I5、I3平臺(tái)則可以看作是單芯片平臺(tái)全面普及的契機(jī)。在北橋芯片取消后,TAC 2.0機(jī)箱才能滿足新平臺(tái)的散熱要求,特別是在使用獨(dú)立顯卡的情況下,TAC 2.0機(jī)箱幾乎成為消費(fèi)者今后裝機(jī)的唯一選擇。■
來源:航嘉
http:m.mangadaku.com/news/2010-1/201016101322.html



